24/05/2023
Fordele ved GaN i Højtydende Elektronik
Galliumnitrid (GaN) har revolutioneret elektronikindustrien, især inden for højtydende applikationer. Dets brede båndgab giver enestående egenskaber som højere nedbrudsspændinger, hvilket muliggør mindre og mere energieffektive enheder. Sammenlignet med siliciumkarbid (SiC) og andre halvledermaterialer, tilbyder GaN en unik kombination af høj frekvens og høj effekt, hvilket gør det til det foretrukne valg for avancerede teknologier. Fra 5G/6G mobilnetværk til satellitkommunikation og datacentre, spiller GaN-baserede High Electron Mobility Transistors (HEMTs) en afgørende rolle.
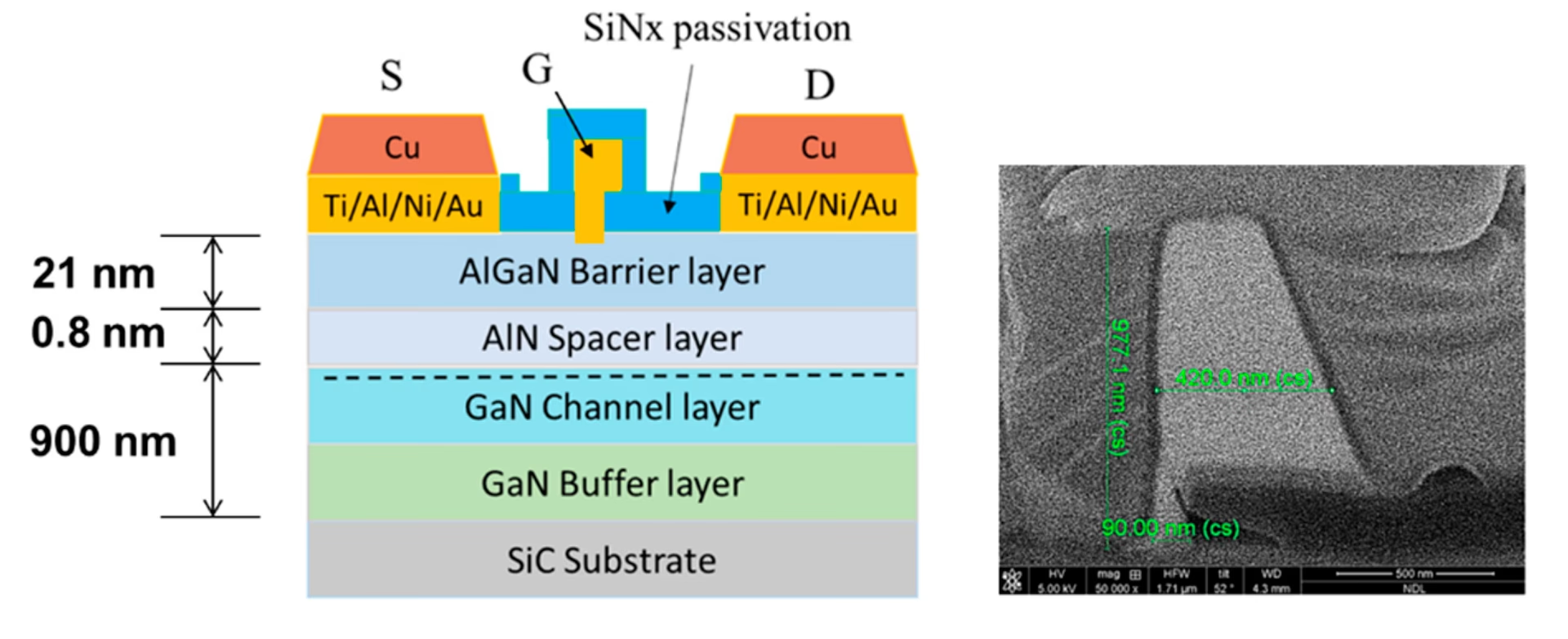
En af de mest kritiske faktorer for HEMT'ers ydeevne er den høje elektronmobilitet i den todimensionelle elektrongas (2DEG), der dannes ved grænsefladen mellem aluminiumgalliumnitrid (AlGaN) og galliumnitrid (GaN). Denne 2DEG opstår på grund af materialernes krystallinske struktur og de elektriske felter, der genereres ved grænsefladen. En højere elektronmobilitet resulterer i lavere kanalsmodstand, hurtigere omskiftningstider og dermed bedre højfrekvente egenskaber.
Udfordringen med Dislokationer og Urenheder
Traditionelt har forskning og industri fokuseret på at opnå en så glat og perfekt grænseflade som muligt mellem AlGaN og GaN. Dette opnås typisk gennem vækst ved høje temperaturer, hvilket minimerer overfladeruhed og urenhedskoncentration. Imidlertid har nyere forskning vist, at en perfekt glat grænseflade måske ikke altid er optimal for at opnå den allerhøjeste elektronmobilitet. Der er stadig udfordringer, der skal overvindes, herunder at øge den faktiske elektronmobilitet fra de typiske 1500 cm²/Vs til de teoretisk forudsagte værdier over 2000 cm²/Vs. Et andet problem er at beskytte bærerne mod at blive fanget af dybe defekter eller "traps".
Dislokationer, som er fejl i krystalstrukturen, kan have en betydelig negativ indflydelse på elektronmobiliteten. Studier har vist, at i strukturer med høj dislokationsdensitet, kan spredning af elektroner på ladede dislokationer forringe transistorens ydeevne markant. Mekanismerne bag denne forringelse kan omfatte spredning på ladede dislokationer, ujævnheder i grænsefladen og punktdefekter omkring dislokationerne. Nogle undersøgelser har dog antydet, at dislokationsmekanismerne er ubetydelige, mens andre peger på en klar sammenhæng mellem dislokationsdensitet og reduceret mobilitet.
Eksperimentelle Tilgange og Resultater
I dette studie blev der anvendt Metal Organic Vapor Phase Epitaxy (MOVPE) til at fremstille HEMT-strukturer på forskellige substrater med varierende dislokationsdensitet (LDD for lav dislokationsdensitet og HDD for høj dislokationsdensitet). Forskellige vækstbetingelser, herunder temperatur, bærergas (N₂ eller H₂) og prækursorer (TMGa eller TEGa), blev undersøgt for at forstå deres indflydelse på urenhedskoncentrationen og grænsefladens morfologi. Urenhedskoncentrationer af kulstof (C), brint (H), ilt (O) og silicium (Si) blev målt ved hjælp af Secondary Ion Mass Spectrometry (SIMS).
Indflydelse af Dislokationsdensitet på Urenheder
Resultaterne viste, at en højere dislokationsdensitet generelt førte til en øget koncentration af urenheder som kulstof, ilt og brint. Dette indikerer, at der omkring dislokationer dannes regioner med forøget urenhedsopbygning. Specifikt blev det observeret, at kulstof- og iltkoncentrationen steg på nitrogen-sites i GaN-gitteret, mens silicium optog gallium-sites. Dette understøtter hypotesen om, at dislokationer fungerer som "hotspots" for urenhedsintegration. Desuden viste det sig, at vækst i en brintatmosfære generelt øgede kontamineringen af alle studerede urenheder, undtagen brint selv.
V-huller: En Uventet Løsning?
En interessant opdagelse var potentialet i at anvende V-huller (V-pits) til at forbedre elektronmobiliteten, især i strukturer med høj dislokationsdensitet. V-huller er morfologiske defekter, der dannes omkring dislokationer med en skruekomponent under specifikke vækstbetingelser. Traditionelt har V-huller været kendt for at forbedre fotoluminescens-effektiviteten i kvantebrønde, men deres rolle i HEMT'er var mindre udforsket.
Forskningen foreslår, at V-huller kan fungere som en rumlig adskillelse for elektronerne i 2DEG. Når V-huller dannes på overfladen af GaN-kanalen og derefter overgroes med AlGaN-barrieren, kan V-hullernes semipolære flader skabe en lavere polariseringsfelt og en grundere kvantefelt. Dette kan fungere som en barriere, der forhindrer elektronerne i at trænge ind i de områder omkring dislokationerne, hvor der er en højere koncentration af punktdefekter og urenheder. Simulationer bekræftede, at elektrontætheden reduceres nær V-hullerne, og at 2DEG'en undgår disse områder.
Eksperimentelt blev der fremstillet HEMT-strukturer med og uden V-huller. Resultaterne var overraskende: Højere mobilitet blev opnået i strukturer med V-huller, selv i tilfælde hvor SIMS-analyser viste en højere kulstofkoncentration i kanallaget. Dette tyder på, at den rumlige adskillelse, som V-hullerne tilbyder, er mere afgørende for den samlede mobilitet end den øgede, men nu isolerede, urenhedskoncentration.
Optimal V-hul Størrelse
For at opnå den optimale adskillelse er V-hullernes størrelse afgørende. Studier af GaN-kanaler med forskellig tykkelse viste, at en tilstrækkelig tykkelse på over 150 nm var nødvendig for at opnå en V-hul diameter omkring 80 nm. Dette er mindre end den optimale størrelse for luminescence-applikationer (omkring 200 nm), hvilket kan skyldes, at elektronmobilitet er mindre følsom over for defektkoncentration end luminescence-effektivitet. Der er en afvejning mellem V-hullernes størrelse og arealet af den flade grænseflade, hvor 2DEG'en dannes.
Konklusion: Ikke Altid den Glatteste Grænse
Forskningen konkluderer, at en atomart glat AlGaN/GaN grænseflade ikke er en absolut forudsætning for at opnå høj elektronmobilitet i HEMT-strukturer. Tværtimod kan dannelsen af V-huller ved grænsefladen være gavnlig, især i HEMT-strukturer, der indeholder trådende dislokationer. V-huller kan rumligt adskille elektronerne fra de områder omkring dislokationerne, der er påvirket af øget koncentration af punktdefekter og urenheder. Dette forhindrer elektronerne i at blive fanget eller spredt af disse urenheder, hvilket resulterer i en målbar stigning i elektronmobiliteten.
Metoden til at opnå V-huller involverer ændring af vækstbetingelserne for GaN-kanallaget, specifikt ved at skifte fra højtemperaturvækst i H₂-atmosfære til vækst ved 870 °C i N₂-atmosfære med TEGa som prækursor. Denne tilgang, kombineret med en kontrolleret V-hul morfologi, har potentiale til at forbedre ydeevnen af GaN-baserede enheder betydeligt, især i applikationer, hvor en høj grad af pålidelighed og ydeevne under krævende forhold er nødvendig.
Tabel 1: Sammenligning af HEMT-strukturer med og uden V-huller
| Sample ID | GaN Kanal Morfologi | Buffer Teknologi | AlGaN Tykkelse (nm) | AlₓGa₁₋ₓN Sammensætning (x) | Dislokationsdensitet (cm⁻²) | 2D Hall Koncentration (cm⁻²) | Hall Mobilitet (cm²/V s) |
|---|---|---|---|---|---|---|---|
| 347H | Flad grænseflade | GaN:C | 15 | 0.27 | 3 × 10¹⁰ | 1.25 × 10¹³ | 876 |
| 349H | V-huller | GaN:C | 15 | 0.27 | 3 × 10¹⁰ | 1.31 × 10¹³ | 1034 |
| 551L | Flad grænseflade | AlGaN BB | 11 | 0.24 | 9 × 10⁸ | 1.64 × 10¹³ | 1490 |
| 544L | V-huller | AlGaN BB | 11 | 0.24 | 9 × 10⁸ | 1.35 × 10¹³ | 1754 |
| 551H | Flad grænseflade | AlGaN BB | 11 | 0.24 | 3 × 10¹⁰ | 9.50 × 10¹² | 765 |
| 544H | V-huller | AlGaN BB | 11 | 0.24 | 3 × 10¹⁰ | 8.18 × 10¹² | 1123 |
Ofte Stillede Spørgsmål
Er en glat AlGaN/GaN grænseflade altid nødvendig for høj elektronmobilitet?
Nej, forskningen tyder på, at V-huller kan forbedre mobiliteten ved at adskille elektroner fra defektområder, selvom grænsefladen er mere ujævn.
Hvordan påvirker dislokationer elektronmobiliteten?
Dislokationer kan føre til øget urenhedskoncentration og spredning af elektroner, hvilket reducerer mobiliteten.
Hvad er V-huller og hvordan hjælper de?
V-huller er morfologiske defekter, der kan fungere som barrierer og forhindre elektroner i at interagere med urenheder omkring dislokationer.
Hvilken vækstbetingelse fremmer dannelsen af V-huller?
Vækst ved lavere temperaturer (870 °C) i en N₂-atmosfære med TEGa som prækursor fremmer dannelsen af V-huller.
Hvad er den optimale V-hul størrelse for HEMT-applikationer?
En diameter omkring 70-80 nm ser ud til at være optimal for at forbedre elektronmobiliteten i HEMT-strukturer.
Hvis du vil læse andre artikler, der ligner Er en glat GaN/AlGaN grænse nødvendig for høj mobilitet?, kan du besøge kategorien Teknologi.
